TCLAD 熱界面材料 (TIMs)
TCLAD 提供一系列高性能熱介面材料,專為有效傳導電子元件與散熱片或機殼之間的熱量而設計。我們的產品線涵蓋熱傳導墊、間隙填充劑、導熱膏、導熱凝膠、相變材料、導熱油墨等——所有產品均符合 RoHS 規範,並專為提升高功率電子組件的散熱效能而設計。
TCLAD 推出的先進熱界面材料 (TIMs)
您在找什麼?
導熱墊片
TCLAD 導熱填充墊(TCFP)是一種柔軟且具高度貼合性的材料,專為吸收衝擊與振動而設計,同時能有效填補不平整表面之間的空氣間隙。此類墊片採用矽膠基材與導熱填料配方製成,具備卓越的導熱性能。我們的 TCFP 材料提供片狀或客製化裁切形狀,並有多種厚度可供選擇,能為各式各樣的熱管理應用提供多功能且可靠的解決方案。
| TCFP 墊片系列 | 厚度(毫米) | 熱導率 (W/m·K) | 介電常數 (@1 GHz) | 海岸硬度 | 安全資料表 | 技術資料表 |
|---|---|---|---|---|---|---|
| TCFP 2.0 | 0.5 – 10 | 2 | 6.5 | 30 | 下載 | 下載 |
| TCFP 3.0 | 0.5 – 10 | 3 | 6.8 | 45 | 下載 | 下載 |
| TCFP 4.0 | 0.5 – 10 | 4 | 7.0 | 45 | 下載 | 下載 |
| TCFP 5.0 | 0.5 – 10 | 5 | 7.3 | 50 | 下載 | 下載 |
| TCFP 5.1 | 0.5 – 2.0 | 5 | 7.3 | 50 | 下載 | 下載 |
| TCFP 6.0 | 0.5 – 10 | 6 | 7.7 | 55 | 下載 | 下載 |
| TCFP 8.0 | 0.5 – 10 | 8 | 8.1 | 55 | 下載 | 下載 |
| TCFP 10.0 | 0.5 – 4 | 10 | 9.9 | 55 | 下載 | 下載 |
| TCFP 12.0 | 0.5 – 4 | 12 | 9.9 | 55 | 下載 | 下載 |
| TCFP 15.0 | 0.5 – 4 | 15 | 10.5 | 55 | 下載 | 下載 |


導熱填充液
TCLAD 導熱填充液 (TCFL) 是一種雙組分液體系統,需在施作前進行混合。混合完成後,該材料會透過加壓塗佈以消除氣隙,隨後固化成固態以確保長期性能。在液態下,TCFL 既適用於自動化塗佈系統,也適用於手動塗佈系統,能輕鬆貼合複雜的表面形狀,並提供出色的表面潤濕性。 TCFL-RW 型號採用可重工配方,固化後可輕鬆剝離。
| TCFL 空格填充器 | 混合黏度 (cP) | 熱導率 (W/m·K) | 介電常數 (@1 GHz) | 海岸硬度 | 安全資料表 | 技術資料表 |
|---|---|---|---|---|---|---|
| TCFL 2.0 LD | 150,000 | 2.0 | 6.0 | 50 | 下載 | 下載 |
| TCFL 3.5 | 250,000 | 3.5 | 7.5 | 50 | 下載 | 下載 |
| TCFL 3.5 LV | 350,000 | 3.5 | 7.5 | 50 | 下載 | 下載 |
| TCFL 4.0S | 150,000 | 4.0 | 7.5 | 50 | 聯絡我們 | 下載 |
| TCFL 5.0 | 280,000 | 5.0 | 8.0 | 60 | 下載 | 下載 |
| TCFL 5.0 讀寫版 | 350,000 | 5.0 | 8.0 | 50 | 下載 | 下載 |
| TCFL 6.5 | 300,000 | 6.5 | 8.1 | 50 | 下載 | 下載 |
| TCFL 8.0 | 450,000 | 8.0 | 8.3 | 60 | 下載 | 下載 |
| TCFL 10.0 | 320,000 | 10.0 | 8.0 | 60 | 下載 | 下載 |
| TCFL 14.0 | 420,000 | 14.0 | 9.0 | 60 | 下載 | 下載 |
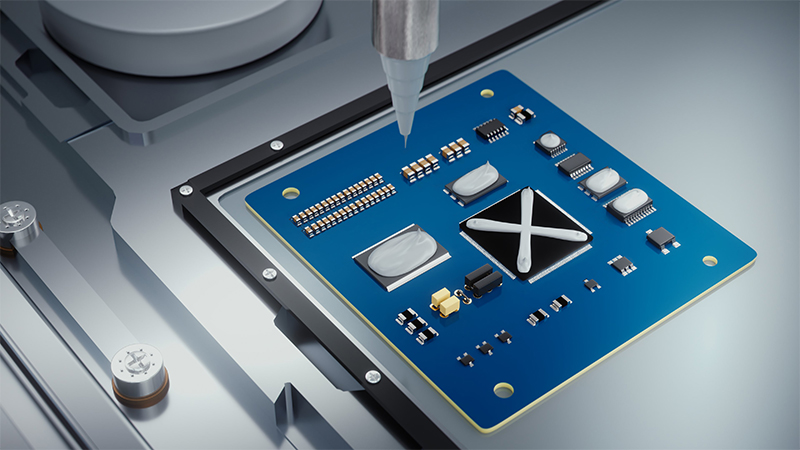

導熱膏系列
TCLAD 的導熱膏系列(TCGS)具備卓越的散熱效能、極薄的接合層厚度以及優異的潤濕性能。此系列產品專為提供低界面阻抗與極低的熱阻而設計,非常適合高功率密度應用,在這些應用中,薄接合層對於實現最佳導熱性至關重要。TCGS 無需固化,且適用於自動點膠與網版印刷兩種製程。
相變材料
TCLAD 的相變材料(PCMs 與 HCAs)在從固態轉變為蠟狀時會吸收並釋放熱能,相較於導熱膏,提供了一種更潔淨、更易於操作的替代方案。其使用方法十分簡單——只需撕下其中一面的背膠,將材料置於目標表面,再撕下另一面的背膠,最後將兩面緊密壓合即可。
導熱黏合劑(HCAs)是一種具備內建黏合強度的相變材料(PCMs),無需額外黏合層即可同時實現高效的熱傳導與元件黏合。
| PCM 系列 | 厚度(毫米) | 熱導率 (W/m·K) | 相變溫度 (°C) | 連續 使用溫度 (°C) | 剪切強度 (MPa) | 安全資料表 | 技術資料表 |
|---|---|---|---|---|---|---|---|
| PCM 3.5 | 0.127 | 3.5 | 50 | -40 至 125 | — | 下載 | 下載 |
| 0.205 | 3.5 | 50 | -40 至 125 | — | |||
| 0.254 | 3.5 | 50 | -40 至 125 | — | |||
| 0.381 | 3.5 | 50 | -40 至 125 | — | |||
| PCM 2.5PI | 0.127 | 32.5 | 50 | -40 至 130 | — | 下載 | 下載 |
| 0.205 | 2.5 | 50 | -40 至 130 | — | |||
| 0.254 | 2.5 | 50 | -40 至 130 | — | |||
| PCM 3.5P | 0.02 | 3.5 | 50 | -40 至 125 | — | 聯絡我們 | 下載 |
| PCM 5.0 | 0.254 | 5.0 | 50 | -40 至 125 | — | 下載 | 下載 |
| PCM 8.5 | 0.254 | 8.5 | 45 | -40 至 130 | — | 下載 | 下載 |
| PCM 9.6 | 0.254 | 9.6 | 45 | -40 至 130 | — | 下載 | 下載 |
| HCA 2.0 | 0.254 | 2.0 | 60 | -50 至 120 | 0.7 | 下載 | 下載 |
| HCA 4.0 | 0.254 | 4.0 | 60 | -50 至 120 | 0.3 | 下載 | 下載 |
| HCA 5.0 | 0.254 | 5.0 | 60 | -50 至 120 | 0.3 | 下載 | 下載 |

導熱凝膠液體
TCLAD 導熱凝膠液 (TCGL) 專為低應力熱管理而設計,具備易於返工及製程靈活性的特點。這款單組分、可貼合的凝膠非常適合含有精密元件的組裝應用,且相容於自動化與手動點膠系統。
| TCTL 凝膠液體 | 最小粘接線 (毫米) | 熱導率 (W/m·K) | 介電常數 (@1 GHz) | 連續 工作溫度 (°C) | 安全資料表 | 技術資料表 |
|---|---|---|---|---|---|---|
| TCGL 2.0 LP | 0.06 | 2.0 | 3.7 | -50 至 200 | 聯絡我們 | 下載 |
| TCGL 2.0 開發版 | 0.15 | 2.0 | 3.7 | -50 至 200 | 聯絡我們 | 下載 |
| TCGL 4.0 | 0.15 | 4.0 | 7.5 | -50 至 200 | 聯絡我們 | 下載 |
| TCGL 4.0A | 0.04 | 4.0 | 7.5 | -50 至 200 | 聯絡我們 | 下載 |
| TCGL 4.0 學習成果 | 0.11 | 4.0 | 7.5 | -50 至 200 | 下載 | 下載 |
| TCGL 6.5C | 0.14 | 6.5 | 8.0 | -50 至 200 | 下載 | 下載 |
| TCGL 7.0 | 0.1 | 7.0 | 8.0 | -50 至 200 | 下載 | 下載 |
| TCGL 10.0 | 0.12 | 10.0 | 9.8 | -50 至 200 | 下載 | 下載 |
| TCGL 12.0 | 0.12 | 12.0 | 10.0 | -50 至 200 | 下載 | 下載 |
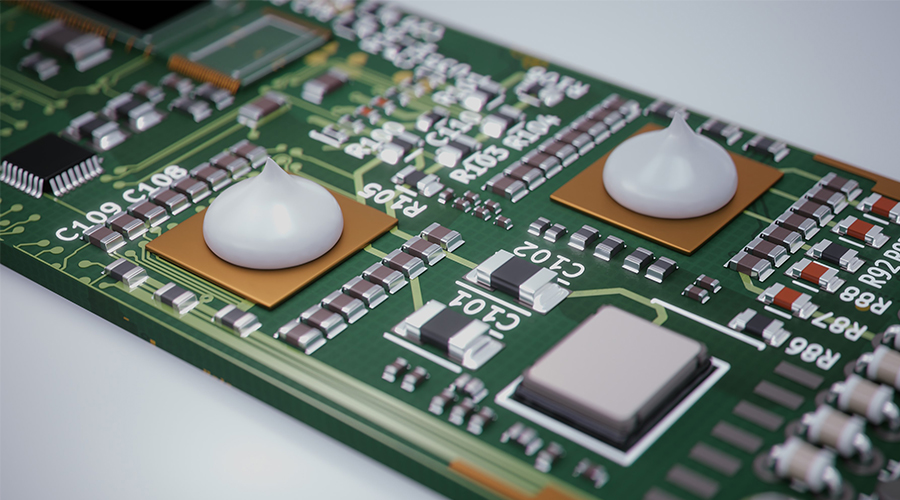
熱固性灌封材料
TCLAD 熱封裝材料(TPMs)是一種雙組分系統,經混合與塗佈後,既能發揮填充劑的功能,又能作為封裝材料,保護敏感電子元件免受灰塵和濕氣等環境因素的影響。其配方設計旨在將功率電晶體等元件的熱量有效導向散熱片或熱擴散片,在提供卓越散熱效能的同時,亦能增強機械結構的完整性。
| TPM 灌封材料 | 固化時間 | 熱導率 (W/m·K) | 介電常數(@1 GHz) | 海岸硬度 | 抗拉強度 (Mpa) | 安全資料表 | 技術資料表 |
|---|---|---|---|---|---|---|---|
| TPM 0.5 | 25°C 下 4 小時 150°C 下 10 分鐘 | 0.5 | 6.6 | 5 C | 0.2 | 下載 | 下載 |
| TPM 1.0 | 25°C 下 4 小時 150°C 下 10 分鐘 | 1.0 | 6.8 | 45 A | 1.3 | 下載 | 下載 |
| TPM 2.0 | 25°C 下 4 小時 150°C 下 10 分鐘 | 2.0 | 6.8 | 65 C | 0.9 | 下載 | 下載 |
| TPM 3.0 | 25°C 下 4 小時 150°C 下 10 分鐘 | 3.0 | 7.1 | 65 C | 0.6 | 下載 | 下載 |
| TPM 4.0 | 25°C 下 4 小時 150°C 下 10 分鐘 | 4.0 | 7.5 | 65 C | 0.5 | 下載 | 下載 |

熱固化墊片
TCLAD 熱固性墊片(TSP 及 TSPF-H)是一種兼具導熱與絕緣性能的材料,經加熱固化後可形成強韌的黏合接合。 TSP 系列採用環氧樹脂為基材,而 TSPF-H 系列則以氟樹脂為基材。兩者均採用高性能導熱填料。這些薄型材料可提供捲材、片材或客製化裁切形狀,並具備雙面黏著層,可置於元件之間以提升熱傳導效率。包裝選項包含散裝、托盤及捲軸,以滿足各種生產需求。
導熱油墨
TCLAD 導熱油墨(TCI)是一種液態環氧樹脂,兼具優異的導熱性能與可靠的電氣絕緣性。此類油墨非常適合用於狹窄空間及幾何形狀複雜的零件,並可適用於點膠、網版印刷及噴塗薄層等製程,適用於多種多樣的應用場景。

TCLAD Inc. 美國製造與全球
創新中心
1600 Orrin Rd, Prescott
WI 54021 美國
電話:+1 715 262 5898
電子郵件:sales.us@tclad.com
TCLAD Europe GmbH
Amelia-Mary-Earhart-Str. 8, 60549 法蘭克福市(
),德國
電話:+886 3 5635598
電子郵件:sales.eu@tclad.com
TCLAD Technology Corp.
300093 台灣新竹市東區
東七路5號1樓,
電話:+886 3 5635598
電子郵件:sales.asia@tclad.com